??在半導體功率器件領域,絕緣柵雙極型晶體管(IGBT)芯片因其高頻率、高電壓和大電流的處理能力,已成為現代電力電子系統的核心。其封裝質量直接決定了模塊的可靠性、導熱性能和長期穩定性。在這一精密制造過程中,微小的污染物或氧化層都可能導致界面失效、熱阻增加乃至器件早期損壞。等離子體清洗技術,作為一種高效、環保的干法清洗工藝,正成為提升IGBT封裝質量和可靠性的關鍵環節。以晟鼎等離子體清洗技術為代表的先進解決方案,為該過程提供了強有力的支持。
一、 IGBT封裝面臨的清潔挑戰
??IGBT封裝工藝復雜,涉及多個關鍵界面,如芯片與直接覆銅(DBC)基板的焊料焊接、DBC中銅層與陶瓷的鍵合、以及終端塑封料與框架/基板的結合等。在這些工序之前,材料表面可能存在以下污染物:
??有機污染物:如樹脂殘留、環境有機分子等,會嚴重阻礙焊接和粘接。
??氧化物:金屬表面(如銅層、鋁鍵合墊)的自然氧化層,會大幅降低焊料的潤濕性和鍵合強度。
??微粒污染:微小的塵埃顆粒,可能引起局部放電或焊接空洞。
??傳統濕法化學清洗存在清洗液殘留、環保壓力大、對精細結構清洗效果不佳等局限性。而等離子體清洗技術則能有效克服這些難題。

二、 等離子體清洗技術的作用原理
??等離子體是物質的第四態,由離子、電子、自由基和中性粒子組成。晟鼎等離子體清洗技術主要在高壓電場作用下,工藝氣體電離形成等離子體,其清洗作用主要通過兩種機制實現:
??化學作用:通入反應氣體(如氧氣、氫氣),產生活性自由基與表面污染物發生化學反應,生成易揮發的產物被真空抽走。例如,氧等離子體能高效去除有機污染物,氫等離子體則可還原金屬氧化物。
??物理作用:通入惰性氣體(如氬氣),高能離子在電場加速下轟擊材料表面,通過物理濺射效應剝離污染物,同時能顯著活化和粗化表面,增大其比表面積。
三、 晟鼎等離子體清洗技術在IGBT封裝中的具體應用與作用
??晟鼎等離子體清洗技術憑借其精準的工藝控制、均勻的清洗效果和穩定的設備性能,在IGBT封裝全流程中扮演著多個重要角色:
??芯片貼裝前清洗:在將IGBT芯片焊接到DBC基板銅層之前,對基板表面進行清洗。晟鼎等離子體可徹底去除銅層表面的氧化層和有機污染物,使焊料(如焊片或燒結銀漿)能夠完美鋪展,形成均勻、低空洞率的焊接層,極大降低熱阻和熱機械應力,提升散熱能力和可靠性。
??DBC/AMB基板預處理:對于直接覆銅(DBC)或活性金屬釬焊(AMB)陶瓷基板,其銅層與陶瓷的鍵合邊緣及表面可能存在微量的工藝殘留或氧化。等離子清洗能凈化并活化表面,確保后續的環氧樹脂涂覆或其它工藝具有優異的附著性。
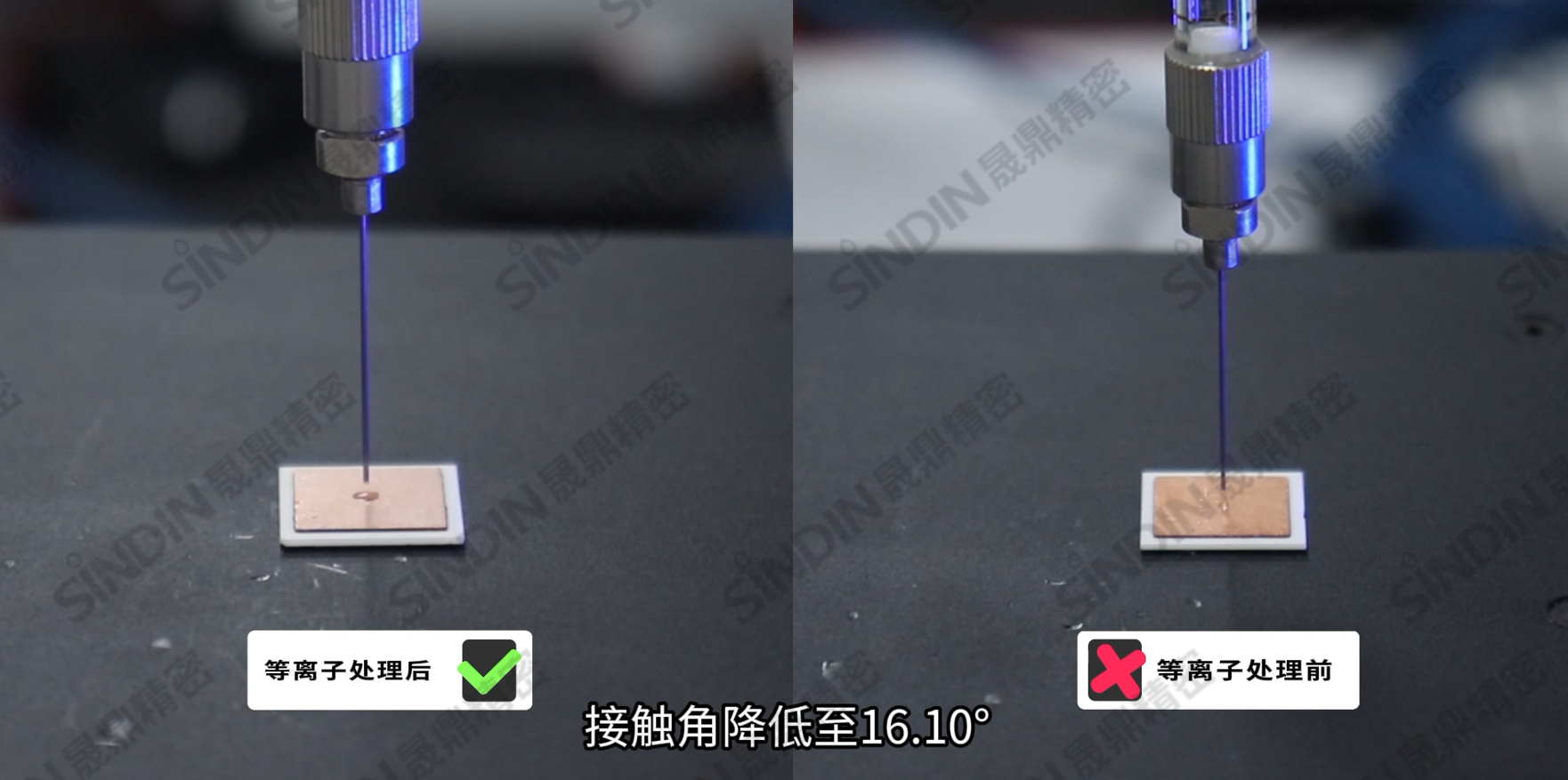
??引線鍵合前清洗:IGBT芯片的鋁鍵合墊表面在空氣中會形成氧化鋁薄膜,嚴重影響金線或鋁線的鍵合強度。晟鼎氫基等離子體(如Ar/H2混合氣體)能有效還原去除這層氧化膜,并輕微活化鋁表面,從而大幅提升鍵合界面的金屬間化合物形成質量,減少虛焊,提高鍵合拉力值和長期可靠性。
??塑封前框架清洗與活化:在轉移成型塑封之前,對環氧塑封料(EMC)與銅框架、陶瓷基板等結合的表面進行等離子處理。晟鼎技術能去除脫模劑殘留等弱邊界層,并顯著提高材料表面能,使環氧樹脂與金屬/陶瓷表面形成牢固的物理和化學結合,有效防止分層、吸濕和腐蝕通道的形成,確保模塊的氣密性和機械強度。
??燒結銀工藝前處理:在采用低溫燒結銀漿作為連接材料的高功率密度IGBT模塊中,基板與芯片背銀表面的潔凈度要求極高。等離子清洗能為燒結銀工藝提供近乎完美的活性表面,促進銀顆粒的致密燒結,形成高導熱、高導電、高可靠性的連接層。
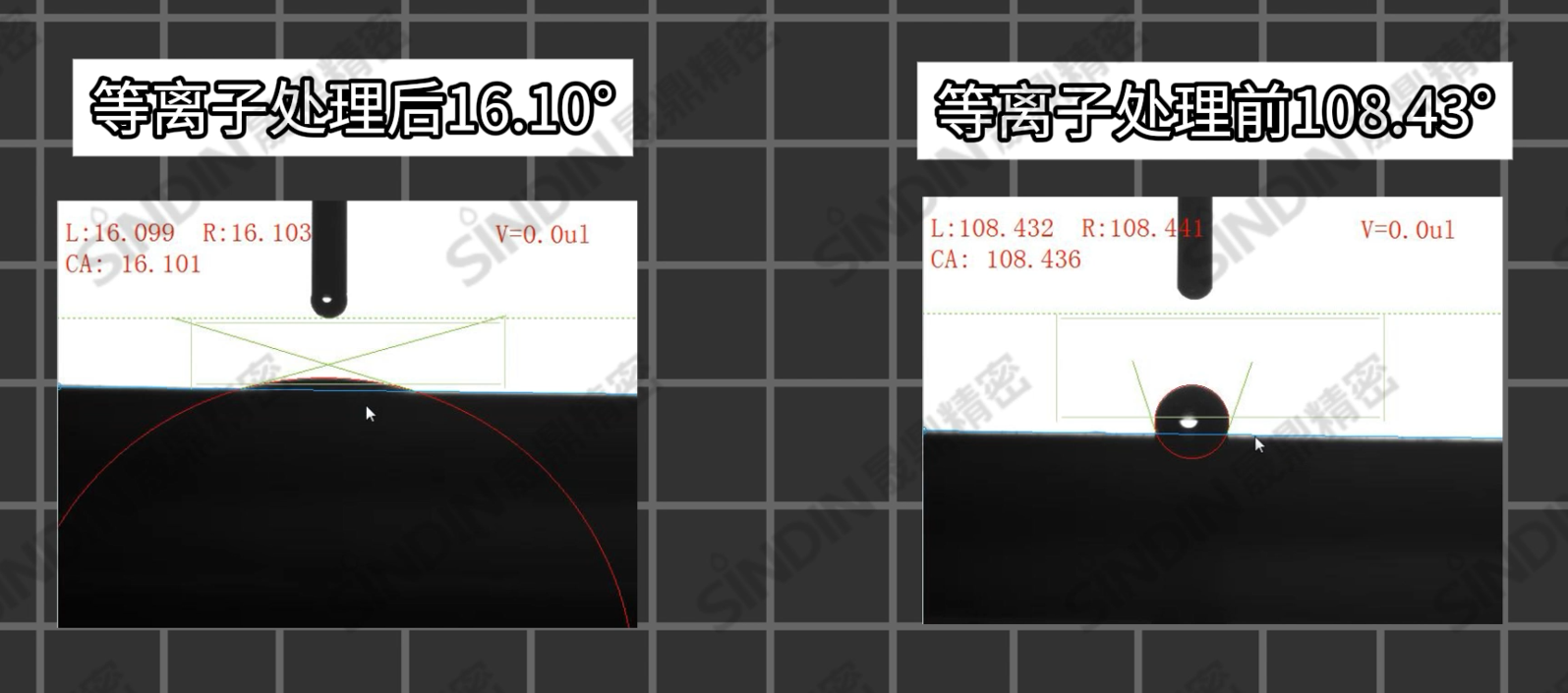
四、 晟鼎等離子體清洗技術的核心優勢
??相較于傳統方法,晟鼎等離子體清洗技術在IGBT封裝應用中凸顯多重優勢:
??高潔凈與高活性:能到達微孔和復雜結構內部,實現納米級清潔,并大幅提升材料表面能。
??低溫無損傷:過程溫度低,避免對精密器件和材料造成熱損傷。
??工藝精準可控:氣體類型、功率、時間等參數可精確調控,適應不同材料與污染類型。
??綠色環保:耗材少,無有害化學廢液,符合現代半導體制造環保標準。
??在線集成能力:易于集成到自動化封裝生產線中,提高生產效率和一致性。
??在追求更高功率密度、更長壽命和更苛刻工作環境的半導體封裝行業,界面質量控制是永恒的課題。等離子體清洗技術,特別是如晟鼎所提供的成熟、穩定、高效的解決方案,已成為IGBT芯片封裝過程中不可或缺的核心工藝之一。它不僅解決了微觀尺度的清潔難題,更通過表面活化從根本上提升了各界面層的結合質量,為制造出高性能、高可靠的功率半導體模塊奠定了堅實基礎,有力推動了新能源汽車、軌道交通、智能電網等關鍵領域的技術進步。